(ロ)選択指針および特性
VALQUA ARMORの8グレードは、その特長にあった環境下での使用が推奨される。VALQUA ARMOR製品の選択指針を図1.2.38‐2に示す。使用環境をプラズマ雰囲気に曝される箇所とプラズマ雰囲気に曝されない箇所に大別すると、プラズマ雰囲気に曝される箇所ではARMOR CRYSTAL、ULTIC ARMOR、SPOQ ARMOR、LABE ARMORおよびHYREC ARMORの使用が推奨され、プラズマ雰囲気に曝されない箇所ではFLID、FLID ARMORの使用が推奨される。そして、使用温度や使用部位の動作等の条件で推奨されるグレードが決定される。
図1.2.38‐2 VALQUA ARMORの選定指針

① FLID/FLID ARMOR(フリッド/フリッドアーマー)
FLIDは液晶・半導体装置用シール材の標準グレードとして開発された製品であり、一般ふっ素ゴムと比較すると純粋性や耐摩耗性にすぐれている。FLID ARMORは特殊低摩擦グレードとして、FLIDをベースに低摩擦性や金属に対する非粘着性を付与した製品である。耐摩耗性の評価として松原式摩擦摩耗試験機を用いた評価結果を図1.2.38‐3に示す。
図1.2.38‐3 耐摩耗性の評価結果

図1.2.38‐4 耐プラズマ性評価
SPOQ ARMOR
Competitive White Perfluoroelastomer

[Specification for Evaluation]
Gas:O2 RF Power:500W,Ir-radiation Time:6hs,Vacuum:0.1 Torr
Dimension of Stage:φ300mm
② SPOQ ARMOR(スポックアーマー)
SPOQ ARMORは耐プラズマ性や非粘着性にすぐれた製品である。耐プラズマ性の評価として、半導体エッチング処理装置で使用された後のシール材表面のSEM写真を図1.2.38‐5に示す。同一使用期間であるものの、他社品で発生していた顕著な劣化はSPOQ ARMORにはみられない。
Evaluation Conditions
Equipment : Etching tool Location : Upper Ring Gate
Gas : O2 : CHF3 = 400 : 20 Plasma Power : 1000W
Temperature : 100 degrees C Wafer Count : Approx. 8000
図1.2.38‐5 耐プラズマ性評価
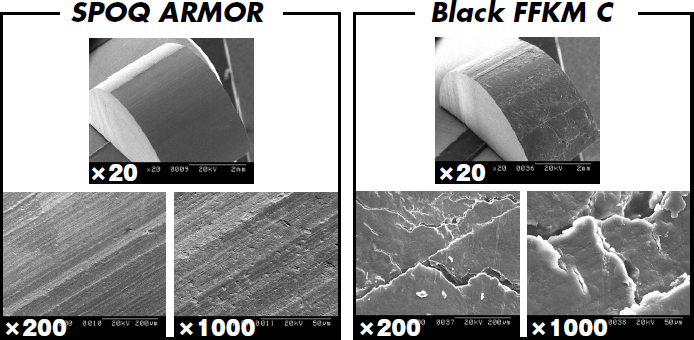
③ ULTIC ARMOR(アルティックアーマー)
ULTIC ARMORは純粋性にすぐれ、半導体成膜処理装置における成膜ガスあるいはその処理チャンバーのクリーニングガスへの耐性に富んだシール材として、すでに多くに実績がある。図1.2.38‐6は実際の半導体成膜処理装置で使用されたシール材表面のSEM写真であるが、ULTIC ARMORが最も試用期間が長いにもかかわらず、他社品で発生していた顕著な劣化はみられない。
Evaluation Conditions
Equipment: HDP CVD Location: Exhaust valve
Gas: SiH4+O2/NF3 Plasma power:RF3200W/Microwave 3200W
Temperature: 120 degrees C Wafer Count: ULTIC ARMORTM: 4794
Black FFKM A: 3,200
White FFKM K : 4,000
図1.2.38‐6 半導体成膜処理装置での成膜ガスおよびクリーニングガス耐性評価
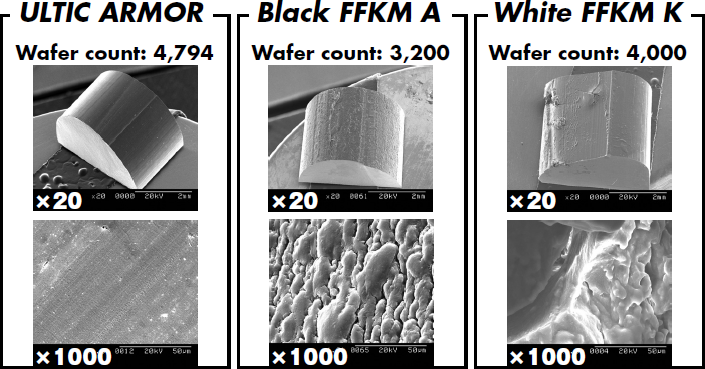
④ ARMOR CRYSTAL/HYREC ARMOR(アーマークリスタル/ハイレックアーマー)
ARMOR CRYSTALおよびHYREC ARMORは純粋性を追求し、琥珀色の透明なシール材であり、ドライエッチング装置等のプラズマ雰囲気下で使用された場合、エッチングによるシール材からのパーティクル発生を抑えた製品である。純粋性の評価としてシール材に含まれる含有金属成分(検出元素はNa、K、Ca、Al、Fe、Mgである)の定量分析結果を図1.2.38‐7に示す。
図1.2.38‐7 含有金属成分定量分析結果