(乙)选用指南及特点
VALQUA ARMOR 的 8 个等级型号,推荐在其擅长的环境下使用。VALQUA ARMOR系列产品的选用指南如图 1.2.38-2 所示。如果将使用环境大致的划分为暴露在等离子环境中的位置与没有暴露在等离子环境中的位置,对于暴露在等离子环境下的位置,推荐使用 ARMOR CRYSTAL、ULTIC ARMOR、SPOQ ARMOR、LABE ARMOR及 HYREC ARMOR,对于未暴露在等离子环境下的位置,则推荐使用 FLID 及 FLIDARMOR。并且,根据使用温度及使用部位的工作等条件,决定推荐的型号。
图 1. 2. 38-2 VALQUA ARMOR 的选用指南

① FLID/FLID ARMOR
FLID 是作为液晶、半导体装置用密封材料的标准型号而开发出的产品,与一般的氟橡胶相比,纯净性与耐磨损性优异。FLID ARMOR 作为特殊低摩擦等级,是在 FLID 的基础上,具有低摩擦性及对金属的非粘附性的产品。作为耐磨损性评价,采用松原式摩擦磨损试验机所得到的评价结果如图 1.2.38-3 所示。
图 1. 2. 38-3 耐磨损性的评价结果

图 1. 2. 38-4 耐等离子性评价
SPOQ ARMOR
Competitive White Perfluoroelastomer

[Specification for Evaluation]
Gas:O2 RF Power:500W,Ir-radiation Time:6hs,Vacuum:0.1 Torr
Dimension of Stage:φ300mm
② SPOQ ARMOR
SPOQ ARMOR 是有着出色的耐等离子性和非粘附性的产品。作为耐等离子性的评价,图 1.2.38-5 所示为在半导体蚀刻处理装置中使用后的密封材料表面的 SEM 照片。在SPOQ ARMOR 上看不到其他公司产品在经过相同使用期间后发生的显著老化。
Evaluation Conditions
Equipment : Etching tool Location : Upper Ring Gate
Gas : O2 : CHF3 = 400 : 20 Plasma Power : 1000W
Temperature : 100 degrees C Wafer Count : Approx. 8000
图 1. 2. 38-5 耐等离子性评价
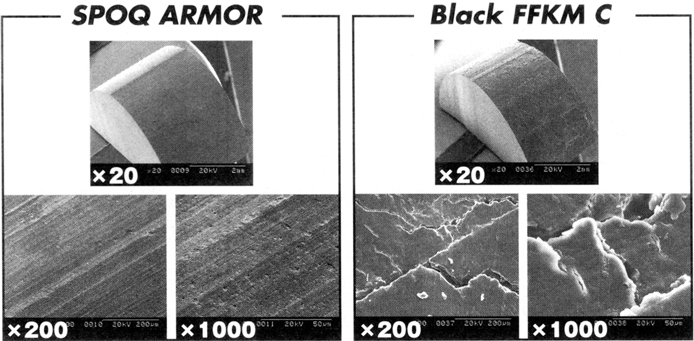
③ ULTIC ARMOR
ULTIC ARMOR 具有优异的纯净性,作为对半导体成膜处理装置中的成膜气体或其处理腔室中的清洗气体具有良好耐性的密封材料,拥有丰富的实绩。图 1.2.38-6 是在实际的半导体成膜处理装置中使用过的密封材料表面的 SEM 照片,尽管试用期间最长,但在 ULTIC ARMOR 上看不到其他公司产品所发生的显著老化。
Evaluation Conditions
Equipment: HDP CVD Location: Exhaust valve
Gas: SiH4+O2/NF3 Plasma power:RF3200W/Microwave 3200W
Temperature: 120 degrees C Wafer Count: ULTIC ARMORTM: 4794
Black FFKM A: 3,200
White FFKM K : 4,000
图 1. 2. 38-6 对半导体成膜处理装置中的成膜气体及清洗气体耐性的评价

④ ARMOR CRYSTAL/HYREC ARMOR
ARMOR CRYSTAL 及 HYREC ARMOR 是为了追求纯净性,而没有添加任何无机填充材料的琥珀色透明密封材料。当用于干蚀装置等等离子环境下时,能够抑制因侵蚀而导致从密封材料逸出微粒。作为纯净性评价,密封材料中的含有金属成分(检测出金属为 Na、K、Ca、Al、Fe、Mg。)的定量分析结果如图 1.2.38-7 所示。
图 1. 2. 38-7 含有金属成分定量分析结果




